PCB-Verformungen gehören zu den am meisten unterschätzten Risiken in der modernen Elektronikfertigung.
As board density increases and component packages become larger—especially BGA and QFN—board flatness during reflow becomes critical. Even a small deformation can significantly affect solder joint reliability and assembly yield.
Dieser Artikel erklärt, was zu einer Verformung von Leiterplatten führt, wie sie sich während des Reflow-Lötens verhält, wie sie gemessen wird und wie Ingenieure das Risiko verringern können.
Inhaltsübersicht
Was ist PCB-Verzug?
PCB-Verformung bezieht sich auf eine Verformung der Leiterplatte außerhalb der Ebene, entweder:
- Bogen (gleichmäßige Krümmung)
- Verdrehung (diagonale Verzerrung)
- Lokalisierte Verformung
Verformungen können bereits vor der Montage auftreten, nehmen jedoch häufig während der thermischen Belastung beim Reflow-Löten zu.
Die Ebenheit bei Raumtemperatur garantiert nicht die Ebenheit bei maximaler Reflow-Temperatur.
Warum sich die Verformung während des Reflow-Prozesses verstärkt
During reflow, PCB temperature typically rises to 230–250°C (lead-free process).
Bei erhöhten Temperaturen:
- Harz wird weich
- Kupfer und Substrat dehnen sich aus
- CTE-Fehlanpassung wird deutlicher
- Interne Spannung verteilt sich neu
Wenn der PCB-Aufbau nicht symmetrisch ist, kommt es zu einer ungleichmäßigen Wärmeausdehnung, was zu Verformungen führt.
Dieses Verhalten hängt stark mit dem PCB-Herstellungsprozess
Die Laminierungsqualität und die Kupferverteilung beeinflussen direkt die inneren Spannungen.
Hauptursachen für Verformungen von Leiterplatten
1. Asymmetrischer Stapelaufbau
Wenn die Schichtverteilung ungleichmäßig ist (z. B. viel Kupfer auf einer Seite), unterscheiden sich die Ausdehnungskräfte über die gesamte Plattendicke hinweg.
Dies führt zu einer Verformung während des Erhitzens.
Ein ausgewogenes Stapeldesign ist eine der wirksamsten Präventionsmaßnahmen.
2. Ungleichmäßige Kupferverteilung
Große Kupferflächen auf der einen Seite und spärliche Verdrahtung auf der anderen Seite führen zu einem thermischen Ungleichgewicht.
Kupfer dehnt sich anders aus als Harz und vergrößert unter Hitzeeinwirkung seine Krümmung.
Kupferausgleichstechniken reduzieren dieses Risiko.
3. Material-CTE-Fehlanpassung
Verschiedene Materialien dehnen sich unterschiedlich stark aus.
Diskrepanz zwischen:
- Kernmaterial
- Prepreg-Harz
- Kupferschichten
kann die Verformung während des Temperaturwechsels verstärken.
4. Große BGA-Gehäuse
Große BGA-Bauteile erhöhen die lokale Belastung während des Reflow-Lötens.
Wenn die Leiterplattenoberfläche nicht eben ist, kann es zu ungleichmäßigen Lötstellen kommen, was zu den in Zuverlässigkeit von BGA-Lötstellen
5. Hohe Reflow-Temperatur
Bleifreies Löten erhöht die Spitzentemperatur im Vergleich zu bleihaltigen Verfahren.
Höhere Temperaturen erhöhen die Ausdehnung und die Spannung.
Eine zu lange Einweichzeit kann die Verformung noch verstärken.

Wie sich Verformungen von Leiterplatten auf die Montage auswirken
Verformungen können folgende Ursachen haben:
- Kopf-im-Kissen-Defekte
- Unvollständige Lötbenetzung
- Unebene Lötstellenhöhe
- Erhöhtes Risiko einer BGA-Ermüdung
- Fehlausrichtung der Komponenten
Selbst wenn die Leiterplatte die elektrischen Tests besteht, kann es durch Verformungen während des Reflow-Lötens zu langfristigen Zuverlässigkeitsproblemen kommen.
Warpage is not just cosmetic—it is a structural reliability concern.
Messung der Verformung von Leiterplatten
Die Verformung wird in der Regel in Prozent gemessen: Branchenrichtlinien beschränken die Verformung für eine zuverlässige Montage je nach Anwendung häufig auf etwa 0,75 % oder weniger.
Zu den Messmethoden gehören:
- Optische Ebenheitsmessung
- Shadow moiré systems
- 3D-Verformungsanalyse während des Temperaturwechsels
Die Überwachung der Verformung bei der Reflow-Temperatur liefert aussagekräftigere Daten als die Messung bei Raumtemperatur allein.
Verformung und Fertigungstoleranzen bei Leiterplatten
Maßtoleranzen beeinflussen das Verzugsverhalten.
Eine strenge Dickenkontrolle und eine ausgewogene Laminierung reduzieren das Verformungsrisiko.
Siehe: Toleranzen bei der Leiterplattenherstellung
Das Stapeldesign muss sowohl mechanische als auch elektrische Anforderungen berücksichtigen.
Strategien zur Reduzierung von Verformungen
Ingenieure können Risiken reduzieren durch:
- Symmetrischer Schichtaufbau
- Ausgewogene Kupferverteilung
- Vermeidung von übermäßigem Kupfer nur auf den äußeren Schichten
- Auswahl geeigneter Tg-Materialien
- Kontrolle der Plattendicke
- Reduzierung der Plattengröße, wenn möglich
Eine frühzeitige DFM-Prüfung hilft, Ungleichgewichte vor der Produktion zu erkennen.
Prozesssteuerungsstrategien während der Montage
Zu den Fertigungskontrollen gehören:
- Optimiertes Reflow-Profil
- Kontrollierte Heizrate
- Geeignete Stützwerkzeuge während des Reflow-Lötens
- Plattendesign mit ausreichender Steifigkeit
Montage und Fertigung müssen zusammenarbeiten, um Verformungen zu vermeiden.
Verformung in Anwendungen mit hoher Zuverlässigkeit
Automobil- und Industrieelektronik sind häufig wiederholten Temperaturwechseln ausgesetzt.
Selbst geringfügige anfängliche Verformungen können mit der Zeit die Ermüdungsrissbildung beschleunigen.
Langfristige Zuverlässigkeit erfordert:
- Stabile Fertigung
- Kontrollierte Montage
- Geeignete Materialauswahl
- Validierte Thermoszyklusleistung
Häufig gestellte Fragen (FAQ)
A: In der Regel unter 0,75 %, aber die Anforderungen variieren je nach Bauteilgröße und Zuverlässigkeitsklasse.
A: Dickere Leiterplatten sind im Allgemeinen widerstandsfähiger gegen Verformungen, aber die Symmetrie des Lagenaufbaus und die Kupferbalance sind wichtiger als die Dicke allein.
A: Nein. Thermische Ausdehnung verursacht immer eine gewisse Verformung. Das Ziel ist es, diese innerhalb akzeptabler Grenzen zu halten.
A: Beides. Die Fertigung kontrolliert die innere Spannung, während das thermische Profil der Baugruppe die Verformung während des Reflow-Lötens beeinflusst.
A: Advanced measurement systems such as shadow moiré allow deformation analysis under controlled heating conditions.
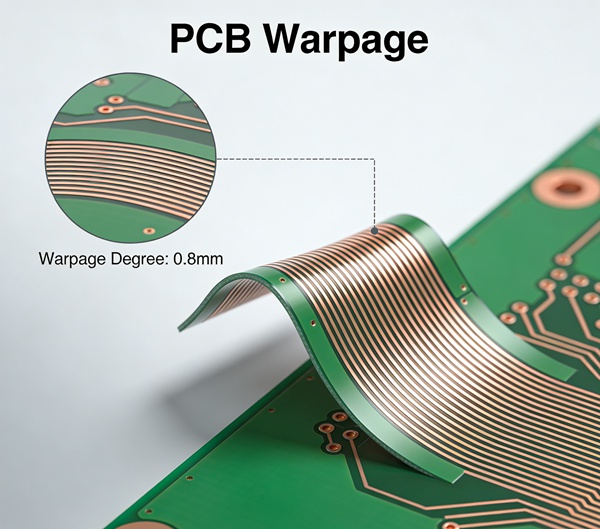
Schlussfolgerung
Die Verformung von Leiterplatten während des Reflow-Lötens ist ein mechanisches Phänomen, das durch ein Ungleichgewicht der Wärmeausdehnung verursacht wird.
Es wirkt sich direkt aus auf BGA-Zuverlässigkeit, Lötstellenintegrität und langfristige Produktstabilität.
Die Vermeidung von Verformungen erfordert eine Abstimmung zwischen Leiterplattenentwurf, Fertigungskontrolle und Optimierung des Montageprozesses.
Understanding deformation behavior at elevated temperature—not just room temperature—is essential for modern high-density electronics.