Inhaltsübersicht
Was ist Via-in-Pad?
Die Via-in-Pad-Technologie (VIP) bedeutet im Wesentlichen Platzierung von Durchkontaktierungen direkt innerhalb der BauteilpadsStellen Sie sich das so vor: Während bei herkömmlichen Designs Durchkontaktierungen neben den Pads platziert werden, können Durchkontaktierungen bei VIP innerhalb der Pads selbst „residieren“.
Warum Via-in-Pad verwenden?
Anwendungsszenario-Vergleichstabelle
| Anwendungsszenario | Schwierigkeiten beim traditionellen Design | VIP-Lösung |
|---|---|---|
| BGA-Chips | Pins zu dicht, kein Platz für Durchkontaktierungen | Die Leiterbahnen sind unter den Pads versteckt, was Platz spart. |
| Hochfrequenz-Schaltungen | Lange Signalwege beeinträchtigen die Leistung | Wege verkürzen, Signalqualität verbessern |
| Leistungsmodule | Schlechte Wärmeableitung, Chips überhitzen | Verbesserung der Wärmeableitung durch Durchkontaktierungen |
Real CaseDas BGA-Gehäuse eines Prozessors auf einer Smartphone-Hauptplatine hat einen Pin-Abstand von nur 0,4 mm – ohne VIP wäre eine Verdrahtung unmöglich!
Zwei Kernprozesse: Harzverfüllung vs. Galvanisierungsfüllung
Prozessvergleichstabelle
| Charakteristisch | Harzverstopfung | Galvanische Beschichtung |
|---|---|---|
| Kosten | Mittel | Hoch |
| Schwierigkeit | Relativ einfach | Schwierig |
| Oberflächenebenheit | Gut (muss geschliffen werden) | Ausgezeichnet |
| Wärmeleitfähigkeit | Durchschnitt | Ausgezeichnet |
| Anwendungsszenarien | Standard-BGA | Hochwertige Chips, hohe Anforderungen an die Wärmeableitung |
Wichtige Punkte für die Praxis des Harzstopfens
Die Materialauswahl ist entscheidend:
Hochwertiges Harz = Geringe Schrumpfrate + Hoher Tg-Wert + Angepasster CTE
Wenn die Schrumpfrate des Harzes zu hoch ist, tritt ein „Pitting-Effekt“ auf – ähnlich wie bei einer Straßensenkung –, der zu einer Vertiefung der Pad-Oberfläche und damit zu Lötfehlern führt.
Prozesskontrollpunkte:
- Sauberkeit: Verunreinigungen in Bohrlöchern? Auf keinen Fall! Wie bei einer sterilen Operation in der Chirurgie.
- Filling Pressure: Too high → resin overflow; Too low → incomplete filling
- Aushärtungskurve: Ein schneller Temperaturanstieg verursacht Blasenbildung, ähnlich wie beim Backen, wenn man die Hitze reguliert.
Insiderwissen über Galvanisierungs-Fülltechnologie
Hohe Anforderungen an die Ausrüstung:
- Anlage zur horizontalen Kupferabscheidung
- Impuls-Galvanisierungssystem
- Präzisionssteuerungssoftware
ErfolgsindikatorBei der Querschnittsprüfung muss das Loch wie eine massive Kupfersäule ohne Hohlräume aussehen!

„Leitfaden zur Vermeidung von Fallstricken“ für die Entwurfsphase
Goldene Regeln für die Blendenkonstruktion
Empfohlen: 0,10 mm Laser-Via
Warnung: Bei Löchern > 0,15 mm steigt die Schwierigkeit beim Füllen drastisch an!
Berechnung der Pad-Größe:
Pad diameter ≥ Hole diameter + 0.20mm
Beispiel: Bei einem Lochdurchmesser von 0,10 mm sollte das Pad mindestens 0,30 mm groß sein.
Weisheit bei der Materialauswahl
- Grundmaterial: Wählen Sie FR-4 TG170 oder höher für hohe Temperaturbeständigkeit.
- Kupferfolie: Muss mit dem Galvanisierungsprozess kompatibel sein.
- Frühzeitige Kommunikation: Gehen Sie nicht davon aus, dass Hersteller alles können!
Produktionsprozess
Fertigungsprozessablauf
Drilling → Hole Metallization → Plugging/Filling → Surface Treatment → Inspection
Wichtige Kontrollpunkte
Bohrphase:
- Die „Hitze“ beim Laserbohren richtig kontrollieren
- Spiegelglatte Lochwände sind ideal
Checkliste für die Qualität der Steckverbindung:
- Oberflächenebenheit: Vertiefung < 25 µm
- Füllrate: >95 %
- Blasen: Null Toleranz
- Sauberkeit: Keine Verunreinigung
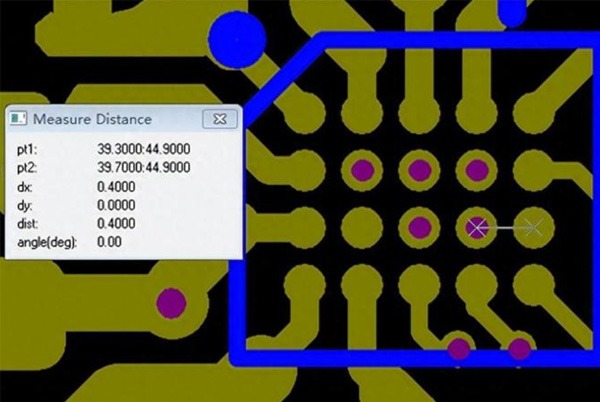
Qualitätskontrolle
Umfassende Inspektionsmethoden
| Prüfverfahren | Was zu überprüfen ist | Standardanforderungen |
|---|---|---|
| Mikroschliff-Analyse | Interne Struktur | Keine Hohlräume, Kupferdicke entspricht den Normen |
| AOI-Inspektion | Oberflächenfehler | Keine Depression, keine Kontamination |
| Röntgenstrahlung | Interne Füllung | Keine großflächigen Hohlräume |
| Elektrische Prüfung | Verbindungsleistung | 100 % Durchgangsprüfung |
Zuverlässigkeitstest-Elemente
- Thermal Stress Test: 288℃ solder pot immersion for 10 seconds, check for board delamination
- Temperature Cycling: -55℃ to 125℃ repeated testing, verify lifespan
- Thermoschockprüfung: Sofortiger Wechsel zwischen extremer Kälte und Hitze, Prüfung der Materialhaftung
Wann sollten Sie Via-in-Pad verwenden?
Empfohlene Anwendungsszenarien
- Bei BGA-Chips, insbesondere mit einem Abstand von <0,8 mm
- CPU-/GPU-Stromanschlüsse erfordern eine gute Wärmeableitung.
- Hochfrequente Differenzsignale erfordern eine konstante Impedanz.
- Hochgeschwindigkeitsschnittstellen wie HDMI, USB 3.0
Mit Vorsicht verwenden
- Kostensensible Projekte erfordern Kompromisse.
- Wenn die Prozessfähigkeit des Herstellers unzureichend ist
- Wenn traditionelle Designs für Standard-Pitch-Komponenten ausreichen
Zusammenfassung
Via-in-Pad ist eine Schlüsseltechnologie für das Design von Leiterplatten mit hoher Dichte, deren erfolgreiche Umsetzung eine enge Zusammenarbeit zwischen Design- und Fertigungsteams erfordert. Durch die Auswahl geeigneter Verfahren, strenge Qualitätskontrollen und gründliche Zuverlässigkeitsprüfungen lassen sich die Vorteile dieser Technologie in Bezug auf Platzersparnis und Leistungssteigerung voll ausschöpfen.
