Índice
O que é Via-in-Pad?
A tecnologia Via-in-Pad (VIP) significa essencialmente colocação de vias diretamente dentro das almofadas dos componentesPense da seguinte forma: enquanto os projetos tradicionais colocam as vias ao lado dos pads, o VIP permite que as vias “residem” dentro dos próprios pads.
Por que usar o Via-in-Pad?
Tabela comparativa de cenários de aplicação
| Cenário do aplicativo | Pontos fracos do design tradicional | Solução VIP |
|---|---|---|
| Chips BGA | Pinos muito densos, sem espaço para vias | As vias ficam ocultas sob as almofadas, economizando espaço. |
| Circuitos de alta frequência | Os percursos longos dos sinais afetam o desempenho | Encurtar caminhos, melhorar a qualidade do sinal |
| Módulos de potência | Má dissipação de calor, superaquecimento dos chips | Melhore a dissipação de calor através de vias |
Caso realO pacote BGA de um processador na placa-mãe de um smartphone tem um espaçamento entre pinos de apenas 0,4 mm — sem VIP, o roteamento seria impossível!
Dois processos principais: tamponamento com resina vs. enchimento por galvanoplastia
Tabela comparativa de processos
| Característica | Tamponamento com resina | Enchimento por galvanoplastia |
|---|---|---|
| Custo | Médio | Alta |
| Dificuldade | Relativamente fácil | Difícil |
| Planicidade da superfície | Bom (requer moagem) | Excelente |
| Condutividade térmica | Média | Excelente |
| Cenários de aplicativos | BGA padrão | Chips de alta tecnologia, requisitos elevados de dissipação de calor |
Pontos-chave para a prática de tamponamento com resina
A seleção do material é fundamental:
Resina de alta qualidade = Baixa taxa de retração + Alto valor de Tg + CTE compatível
Se a taxa de retração da resina for muito alta, ocorre um “efeito de corrosão” — semelhante ao afundamento da estrada, causando depressão na superfície da almofada e levando a defeitos de soldagem.
Pontos de controle do processo:
- Limpeza: Contaminação nos orifícios? Absolutamente não! Como uma operação cirúrgica em ambiente estéril.
- Filling Pressure: Too high → resin overflow; Too low → incomplete filling
- Curva de cura: O aumento rápido da temperatura causa bolhas, como controlar o calor ao assar.
Conhecimento especializado sobre tecnologia de enchimento por galvanoplastia
Requisitos elevados de equipamento:
- Equipamento de deposição horizontal de cobre
- Sistema de galvanoplastia por pulsos
- Software de controle de precisão
Indicador de sucessoDurante a inspeção transversal, o orifício deve ser como um pilar de cobre sólido, sem espaços vazios!

“Guia para evitar armadilhas” para a fase de projeto
Regras de ouro para o design de aberturas
Recomendado: via a laser de 0,10 mm
Aviso: A dificuldade de preenchimento aumenta drasticamente para orifícios >0,15 mm!
Cálculo do tamanho da almofada:
Pad diameter ≥ Hole diameter + 0.20mm
Exemplo: Para um diâmetro de furo de 0,10 mm, a almofada deve ter pelo menos 0,30 mm.
Sabedoria na seleção de materiais
- Material base: Escolha FR-4 TG170 ou superior para resistência a altas temperaturas
- Folha de cobre: Deve ser compatível com o processo de galvanoplastia.
- Comunicação antecipada: não presuma que os fabricantes podem fazer tudo!
Processo de produção
Fluxo do processo de fabricação
Drilling → Hole Metallization → Plugging/Filling → Surface Treatment → Inspection
Principais pontos de controle
Fase de perfuração:
- Controle adequadamente o “calor” para a perfuração a laser
- Paredes lisas como espelho são ideais
Lista de verificação da qualidade da fase de conexão:
- Planicidade da superfície: Depressão <25um
- Taxa de preenchimento: >95%
- Bolhas: Tolerância zero
- Limpeza: Sem contaminação
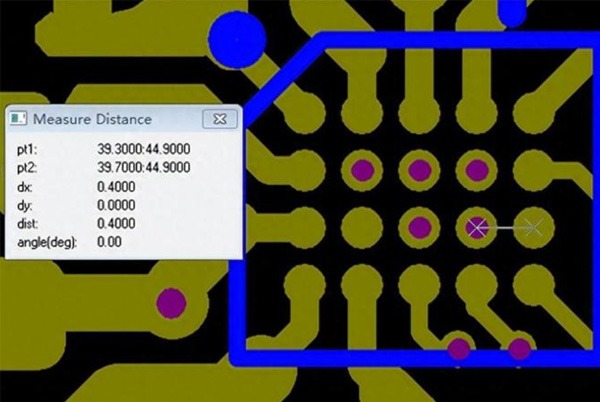
Inspeção de qualidade
Métodos de inspeção abrangentes
| Método de inspeção | O que verificar | Requisitos padrão |
|---|---|---|
| Análise de Microsecção | Estrutura interna | Sem vazios, a espessura do cobre atende às normas |
| Inspeção AOI | Defeitos superficiais | Sem depressão, sem contaminação |
| Raio X | Preenchimento interno | Sem grandes espaços vazios |
| Teste elétrico | Desempenho da conexão | Teste de continuidade de 100% |
Itens do teste de confiabilidade
- Thermal Stress Test: 288℃ solder pot immersion for 10 seconds, check for board delamination
- Temperature Cycling: -55℃ to 125℃ repeated testing, verify lifespan
- Teste de choque térmico: alternância instantânea entre frio e calor extremos, teste de aderência do material
Quando você deve usar o Via-in-Pad?
Cenários de aplicação recomendados
- Em chips BGA, especialmente com um passo <0,8 mm
- Os pinos de alimentação da CPU/GPU requerem uma boa dissipação de calor.
- Sinais diferenciais de alta frequência requerem impedância consistente
- Interfaces de alta velocidade, como HDMI, USB 3.0
Use com cuidado
- Projetos sensíveis ao custo exigem concessões
- Quando a capacidade do processo do fabricante é insuficiente
- Quando os projetos tradicionais são suficientes para componentes de passo padrão
Resumo
A Via-in-Pad é uma tecnologia fundamental para o projeto de placas de circuito impresso de alta densidade, exigindo uma estreita colaboração entre as equipes de projeto e fabricação para uma implementação bem-sucedida. Por meio da seleção adequada do processo, do rigoroso controle de qualidade e da verificação completa da confiabilidade, suas vantagens em termos de economia de espaço e melhoria de desempenho podem ser plenamente aproveitadas.
